01
Introdução
O corte de wafer é uma parte importante da fabricação de dispositivos semicondutores. O método e a qualidade do corte em cubos afetam diretamente a espessura, a rugosidade, as dimensões e os custos de produção do wafer, e têm um impacto significativo na fabricação do dispositivo. O carboneto de silício, como material semicondutor de terceira{2}}geração, é um material importante que impulsiona a revolução elétrica. O custo de produção de carboneto de silício cristalino de alta-qualidade é extremamente alto, e as pessoas geralmente esperam cortar um lingote grande de carboneto de silício em tantos substratos finos de wafer de carboneto de silício quanto possível. Ao mesmo tempo, o crescimento da indústria levou a tamanhos de wafer cada vez maiores, o que aumentou os requisitos para os processos de corte em cubos. Porém, o carboneto de silício é extremamente duro, com dureza Mohs de 9,5, perdendo apenas para o diamante (10), e também é quebradiço, dificultando o corte. Atualmente, os métodos industriais geralmente usam serragem com fio de lama ou serragem com fio diamantado. Durante o corte, serras de fio fixo igualmente espaçadas são colocadas ao redor do lingote de carboneto de silício, e o lingote é cortado usando serras de fio esticado. Usando o método de serra de fio, a separação de wafers de um lingote de 6 polegadas de diâmetro leva aproximadamente 100 horas. Os wafers resultantes têm cortes relativamente largos, superfícies mais ásperas e perdas de material de até 46%. Isto aumenta o custo da utilização de materiais de carboneto de silício e limita o seu desenvolvimento na indústria de semicondutores, destacando a necessidade urgente de investigação de novas tecnologias de corte de pastilhas de carboneto de silício.
Nos últimos anos, o uso da tecnologia de corte a laser tornou-se cada vez mais popular na fabricação de materiais semicondutores. Este método funciona usando um feixe de laser focado para modificar a superfície ou interior do material, separando-o assim. Por ser um processo sem{2}}contato, evita o desgaste da ferramenta e o estresse mecânico. Portanto, melhora muito a rugosidade e a precisão da superfície do wafer, elimina a necessidade de processos de polimento subsequentes, reduz a perda de material, reduz custos e minimiza a poluição ambiental causada pela retificação e polimento tradicionais. A tecnologia de corte a laser tem sido aplicada há muito tempo ao corte de lingotes de silício, mas sua aplicação no campo do carboneto de silício ainda é imatura. Atualmente, existem várias técnicas principais.
02
Corte a laser guiado-por água
A tecnologia de laser{0}guiada por água (Laser MicroJet, LMJ), também conhecida como tecnologia de micro{1}}jato a laser, opera com base no princípio de focar um feixe de laser em um bico à medida que ele passa por uma câmara de água modulada por pressão-. Um jato de água-de baixa pressão é ejetado do bico e, devido à diferença no índice de refração na interface água-ar, um guia de ondas de luz é formado, permitindo que o laser se propague ao longo da direção do fluxo de água. Isso guia um jato de água de alta-pressão para processar e cortar a superfície do material. A principal vantagem do corte a laser-guiado por água está na qualidade do corte. O fluxo de água não apenas resfria a área de corte, reduzindo a deformação térmica e os danos térmicos ao material, mas também remove detritos de processamento. Comparado com o corte com serra de arame, é significativamente mais rápido. No entanto, como a água absorve diferentes comprimentos de onda do laser em graus variados, o comprimento de onda do laser é limitado, principalmente, a 1.064 nm, 532 nm e 355 nm.
Em 1993, o cientista suíço Beruold Richerzhagen propôs pela primeira vez esta tecnologia. Ele fundou a Synova, uma empresa dedicada à pesquisa, desenvolvimento e comercialização de tecnologia de laser guiado-por água, que está na vanguarda internacionalmente. A tecnologia nacional está relativamente atrasada, mas empresas como a Innolight e a Shengguang Silicon Research estão desenvolvendo-a ativamente.

03
Dados furtivos
Stealth Dicing (SD) é uma técnica em que um laser é focado dentro de um wafer de carboneto de silício através de sua superfície para formar uma camada modificada na profundidade desejada, permitindo a separação do wafer. Como não há cortes na superfície do wafer, é possível obter maior precisão de processamento. O processo SD com lasers de pulso de nanossegundos já foi utilizado industrialmente para separar pastilhas de silício. No entanto, durante o processamento SD de carboneto de silício induzido por lasers de pulso de nanossegundos, a duração do pulso é muito maior que o tempo de acoplamento entre elétrons e fônons no carboneto de silício (na escala de picossegundos), resultando em efeitos térmicos. A alta entrada térmica no wafer não apenas torna a separação propensa a se desviar da direção desejada, mas também gera tensão residual significativa, levando a fraturas e clivagem deficiente. Portanto, ao processar carboneto de silício, o processo SD normalmente usa lasers de pulso ultracurtos, o que reduz bastante os efeitos térmicos.
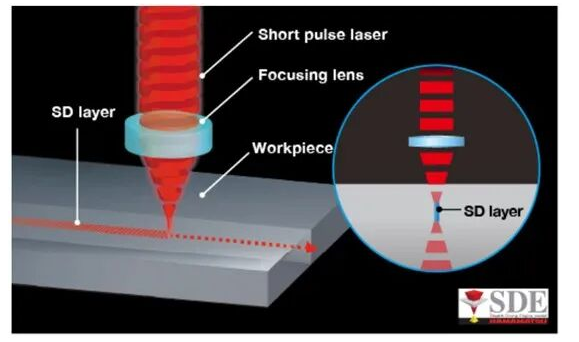
A empresa japonesa DISCO desenvolveu uma tecnologia de corte a laser chamada Key Amorphous-Black Repetitive Absorção (KABRA). Por exemplo, no processamento de lingotes de carboneto de silício com 6- polegadas de diâmetro e 20 mm de espessura, a produtividade dos wafers de carboneto de silício aumentou quatro vezes. O processo KABRA concentra essencialmente o laser dentro do material de carboneto de silício. Através da 'absorção repetitiva preta amorfa', o carboneto de silício é decomposto em silício amorfo e carbono amorfo, formando uma camada que serve como ponto de separação do wafer, conhecida como camada amorfa preta, que absorve mais luz, tornando muito mais fácil separar os wafers.

A tecnologia de wafer Cold Split desenvolvida pela Siltectra, que foi adquirida pela Infineon, pode não apenas dividir vários tipos de lingotes em wafers, mas também reduzir a perda de material em até 90%, com cada wafer perdendo apenas 80 µm, reduzindo, em última análise, os custos totais de produção do dispositivo em até 30%. A tecnologia Cold Split envolve duas etapas: primeiro, um laser irradia o lingote para criar uma camada de delaminação, causando expansão do volume interno no material de carboneto de silício, o que gera tensão de tração e forma uma micro-fissura muito estreita; então, uma etapa de resfriamento do polímero transforma a micro-trinca em uma trinca principal, eventualmente separando o wafer do lingote restante. Em 2019, um terceiro avaliou esta tecnologia e mediu a rugosidade superficial Ra dos wafers divididos como sendo inferior a 3 µm, com os melhores resultados sendo inferiores a 2 µm.
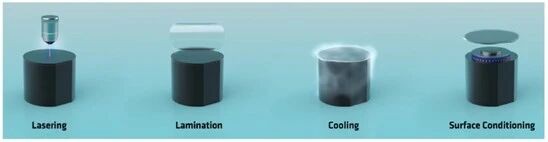
O corte a laser modificado desenvolvido pela empresa chinesa Han's Laser é uma tecnologia de laser usada para separar wafers semicondutores em chips ou matrizes individuais. Este processo também utiliza um feixe de laser preciso para digitalizar e formar uma camada modificada dentro do wafer, permitindo que o wafer quebre ao longo do caminho de varredura do laser sob tensão aplicada, alcançando uma separação precisa.
Figura 5. Fluxo do processo de corte a laser modificado
Atualmente, os fabricantes nacionais dominam a tecnologia de corte em cubos-de carboneto de silício baseada em pasta. No entanto, o corte em cubos tem alta perda de material, baixa eficiência e poluição severa, e está sendo gradualmente substituído pela tecnologia de corte em cubos com fio diamantado. Ao mesmo tempo, o corte a laser se destaca pelas vantagens de desempenho e eficiência. Comparado com as tecnologias tradicionais de processamento de contato mecânico, ele oferece muitos benefícios, incluindo alta eficiência de processamento, linhas estreitas e alta densidade de corte, tornando-o um forte concorrente para substituir o corte em cubos com fio diamantado. Ele abre um novo caminho para a aplicação de materiais semicondutores de próxima-geração, como o carboneto de silício. Com o avanço da tecnologia industrial e o aumento contínuo nos tamanhos dos substratos de carboneto de silício, a tecnologia de corte em cubos de carboneto de silício se desenvolverá rapidamente, e o corte a laser eficiente e de alta-qualidade será uma tendência importante para o futuro corte de carboneto de silício.









